摘要:樂見”蘋果“單挑”英特爾“,瞧,科技進步就是這么“打”出來的。
自蘋果M1芯片發布以來,可謂是一石激起千層浪,在性能方面完全碾壓擠牙膏多年的英特爾處理器。
有媒體報道稱,蘋果將“乘勝追擊”,會在在未來幾年內推出性能更強的第2代和第3代Apple Silicon芯片,其中最快于2023年推出由臺積電代工的3nm Mac芯片,也就是第三代Apple Silicon芯片,其內部代號分別為“Ibiza”、“Lobos”以及“Palma”,這些芯片最多將采用四個Die的設計,最高集成40核 CPU。
這也意味著明年蘋果推出的二代Apple Silicon芯片會和M1一樣,采用5nm的制程,因此也可以推斷出該芯片較當前的M1系列在性能(或指單個核心)和能效方面的提升相對有限。

考慮到臺積電當前在3nm工藝上遇到了挑戰,保守估計其在明年下半年才能實現量產,此番蘋果也是為了保證產品的穩定性。
不過,蘋果似乎提出了新的解決方案,他們計劃在二代芯片上使用兩個單芯片的組合,從而實現更多核的計算能力。舉個例子,在對性能要求較高的臺式Mac上,蘋果可能會以現有的M1 Pro/M1 Max為基礎擴展出兩個Die的芯片,即本質上形成雙M1 Max設計,從而使其(多核)性能實現翻倍。
這里的Die指的是芯片未封裝前的晶粒,是從硅晶元(Wafer)上用激光切割而成的小片(Die),每一個Die就是一個獨立的功能芯片,它的里面又細分為幾個小單元,每個小單元稱為一個chip。我們平常在PCB板子上看到的“芯片”其實就是將Die封裝而成的。
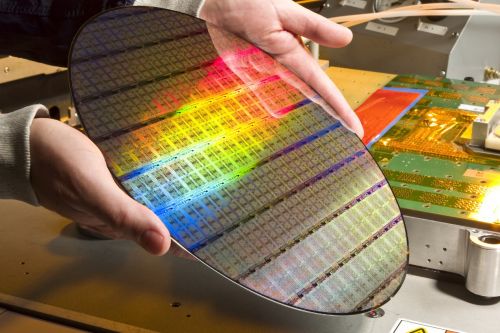
至于為什么要封裝,則是因為它在空氣中會與各種雜質接觸后產生電路腐蝕,影響性能。而且沒有封裝的芯片,很容易在操作過程中產生劃痕。當Die被封裝在一個支撐物之內,這個封裝可以防止物理損壞(如碰撞和劃傷)以及化學腐蝕,并提供對外連接的引腳,這樣就便于將芯片安裝在PCB里。
回到蘋果芯片,之前也有業內人士爆料蘋果的最高端的芯片或將采用四個 Die 的設計,綜上可推測未來的二代和三代Apple Silicon芯片設計都是在M1基礎上的排列組合,通過“堆疊”來獲得更高的處理性能。
蘋果當前已發布的M1芯片的CPU配備 8 核中央處理器,其中包括4個高性能核心和4個高能效核心。而M1 Pro的CPU最高擁有 8 個性能核心與 2 個效能核心,CPU性能比 M1 最多快 70%,GPU 性能最高提升 2 倍。M1 Max的CPU核心還是八大二小共10個,不過GPU圖形核心再次翻番到32個,性能也全部翻倍或者接近翻倍。
由以上參數可見,M1系列的CPU核心最高為10核,如果二代而三代芯片是在此基礎上迭代,2年后芯片最高可以擁有40核也在常理之中,再加上臺積電的3nm工藝,個人PC的處理性能或許會在這幾年內得到質的飛躍。蘋果邁出的成功的一步,也讓愛擠牙膏的老朋友英特爾壓力巨大。
作為消費者,也可以樂見未來個人PC的無限可能。
編輯/大魚然叔








